この半導体特集シリーズの前 2 回の記事では、水性および有機プロセス化学薬品と試薬における ICP-QQQ 性能データを示しました。この記事では、IC 製造プロセス全体で実施されるその他の重要な分析に焦点を移し、基板やフォトレジストなどの主要な材料に重点を置いて説明します。
シリコンウエハ
微量元素の汚染管理はウエハ基板から始まります。電子グレードシリコンには、通常、9~11 ナイン(N)(99.999999~99.999999999 %)という純度レベルが要求されます。これは、200 mm ウエハの表面にわずか数ピコグラム(pg)の金属不純物が存在しても、デバイスの欠陥を引き起こす可能性があるためです。1チップ製造技術の進歩に伴い、高密度アーキテクチャをサポートするために、基板の厳格な品質管理を維持することが必要になります。ICP-MS または ICP-QQQ は、バルクシリコン(Si)分析、および気相分解(VPD)を用いた表面元素抽出の両方に対して使用することができます。
高 Si マトリックスサンプルに関するこの研究では、Agilent 8900 ICP-QQQ を使用して、半導体業界で通常分析されているマトリックスレベルで前処理した 2 種類の Si サンプルを分析しました。1 時間にわたる分析で、Si マトリックスサンプル中に 50 ppt 添加した溶液の測定において優れた精度が達成されており、今回のメソッドで高い効率、堅牢性、および感度が実現されていることがわかりました。2
別の研究では、IAS Inc. の専門家と共同で、8900 ICP-QQQ を自動化システムの一部として使用し、VPD を介して、Si ウエハ基板および関連する層とコーティングから収集した汚染物質をモニタリングしました(図 1)。このシステムは、FAB のコンピュータ統合製造システムに組み込まれており、シリコンウエハの継続した無人運転と汚染管理を可能にします。

VPD 技術では、表面層(未加工の Si、または自然酸化または熱酸化 SiO2)が、フッ酸(HF)蒸気を使用して溶解されます。残留金属イオン汚染物質は、HF と H2O2 の水溶液の液滴内に収集され、この液滴がウエハの表面にわたりスキャンされます。その後、この溶液を、ICP-MS または ICP-QQQ を使用して分析します。表面に存在する H2SiF6 もスキャンする液滴内に収集されるため、溶液には数 ppm の Si が含まれます。これにより、Si ベースの多原子イオン(例えば、31P 上の 30SiH、63Cu 上の 28Si16O19F)が形成されるため、一部の元素の微量分析が困難になります。
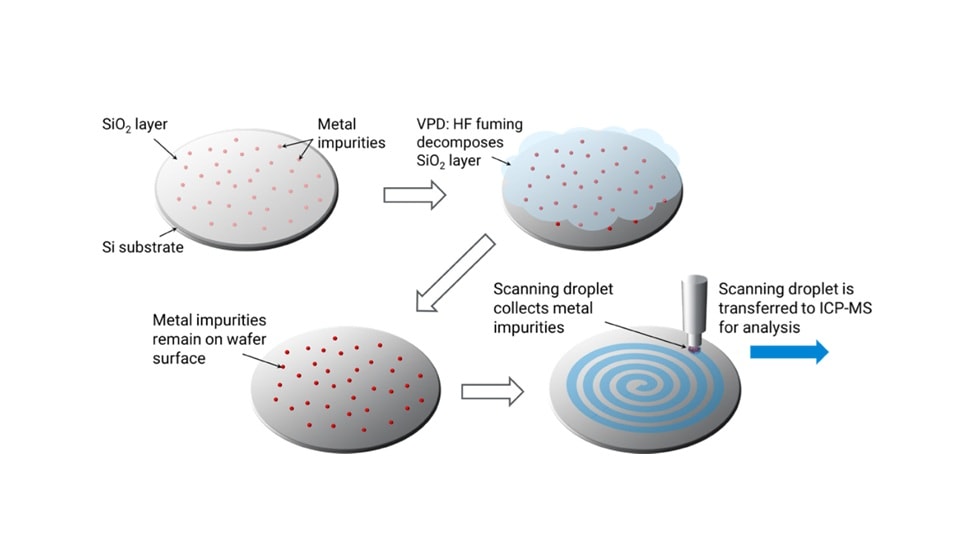
自動化システムを使用することにより、すべての元素で 3.0 E+07 atoms/cm2(< 1 pg/mL)未満の検出下限が達成されており、添加回収のデータより、Si ウエハの超微量汚染物質の測定におけるメソッドの高い精度が示されました。3
ワイドバンドギャップ(WBG)基板
現代のパワー半導体製造では、高度な電気および温度性能をサポートするために、従来の Si ウエハに加え、炭化ケイ素(SiC)や窒化ガリウム(GaN)などのワイドバンドギャップ(WBG)基板にますます依存するようになっています。これらの材料は、より高い破壊電圧と優れた熱耐性により、パワーエレクトロニクス分野で採用が進んでいます。WBG デバイスの電気性能は、Si ベースの半導体と同様に、基板の純度に非常に影響を受けやすくなっています。厳しい性能と品質の要件を満たすために、SiC および GaN ウエハ基板の汚染物質レベルを、適切な分析技法を使用して厳密にモニタリングする必要があります。IAS Inc. チームとの別の共同研究で議論されているように、VPD は非 Si ウエハには適していません。これらの材料は、HF 蒸気により分解できないためです。4そのため、新たに開発されたレーザーアブレーションベースの ICP-MS システムを使用しました。
チップ製造で使用されるその他の材料
チップ製造で使用されるその他の材料、例えば、トリメチルガリウム(TMG)、トリメチルアルミ(TMA)、ジメチル亜鉛(DMZ)、テトラエトキシシラン(TEOS)、トリクロロシラン(TCS)などの金属有機化合物は、ICP-MS または ICP-QQQ による分析に適しています。このような化合物は、有機金属化学気相成長法(MOCVD)や原子層成長法において薄金属膜やエピタキシャル結晶層を増やすために使用されるプリカーサです。
Al、Cu、Ti、Co、Ni、Ta、W、Hf などの純金属は、物理気相成長法(PVD)でウエハ表面に薄金属膜を堆積させるためのスパッタリングターゲットとして使用されます。High-k 誘電体には、Zr、Hf、Sr、Ta、およびレアアース元素(REE)の塩化物とアルコキシドが含まれます。これらの材料にはそれぞれ汚染物質の許容限度があるため、ICP-MS または ICP-QQQ による分析が必要です。
フォトレジスト
フォトレジスト(PR)は、IC 製造のリソグラフィ工程で使用される主要な材料の 1 つであり、ウエハ表面に複雑なパターンをエッチングして IC 回路を形成します。フォトリソグラフィでは、ウエハ表面に投影された UV 画像を使用して、回路の各層に必要な特定のパターンを複製するため、PR は、リソグラフィ工程においてきわめて重要な材料です(図 3)。FAB が、プリント回路基板(PCB)、液晶(LC)と液晶ディスプレイ(LCD)、または IC のいずれを製造しているかに応じて、異なる分類の PR が使用されます。

この包括的な研究では、8900 ICP-QQQ を使用して、3 種類の IC グレードフォトレジストサンプル中の 20 種類の重要な微量元素を定量しました。PR サンプルおよび標準溶液は、プロピレングリコールメチルエーテルアセテート(PGMEA)溶媒で調製しました。
すべての元素について、1 回の取り込みで 1 桁以下の ppt の BEC を達成しており(表 1)、1 時間の分析にわたる 0.1 ppb 添加 PR の繰り返し測定において、優れた精度と回収率を達成しました。3 種類の IC PR サンプルを PGMEA で 10 倍に希釈した後、測定を行いました。PR サンプル中に存在する分析対象物の濃度は、PGMEA の外部検量線に対して測定されており、希釈補正後の結果(元の PR サンプルにおける µg/L 単位)を表 1 に示します。
3 種類の PR サンプルすべてにおいて、低いレベルの汚染が検出されました。一部の元素、例えば、PR サンプル 1 中の Fe、Zn、Sn、およびサンプル 2 中の Ca は、高濃度で存在していました。ただし、いずれの分析対象物も、IC PR における汚染元素の現行の最大許容範囲 1~10 ppb を超えてはいませんでした。サンプル 3 は、モニタリング対象のいずれの元素についても、0.2 ppb を超える濃度では含まれておらず、PR における汚染濃度 < 1 ppb という将来の要件を満たしていました。結果は、複雑な材料の日常的な品質保証試験における 8900 ICP-QQQ メソッドの優れた感度、安定性、堅牢性を実証しています。5

DE-003355





