アジレントは 1990 年代初めより大手半導体メーカーや化学薬品サプライヤと緊密に連携しており、その関係は現在も発展を続けています。アジレントの主要な革新的 ICP-MS 技術の多くは、この業界のニーズに応じて開発されたものです。例えばオフアクシスイオンレンズ、シールドトーチシステムとクールプラズマ、独自の高感度な MS/MS モードの Agilent 8900 ICP-QQQなどです。シリーズ記事のスタートとして、この概要では、8900 半導体用構成 ICP-QQQ による、水系プロセス化学薬品中の超微量濃度の汚染物質の多元素測定について説明します。
集積回路製造の全段階における微量金属のモニタリング
半導体機器の製造では、汚染源を厳密に管理して、不安定なマイクロチップの生産や歩留まり損失を回避する必要があります。金属汚染が問題なのは、絶縁破壊電圧の低下などによって、最終製品の電気的特性に影響を与える可能性があるためです。無機汚染物質の主な発生源は、集積回路(IC)の製造工程で使用されるウエハ基板、化学物質、試薬などです。
水系プロセス化学薬品の多元素分析
図 1 のとおり、IC 製造には多くのウエハ処理ステップがあります。
汚染管理において最も重要なプロセス化学薬品として、超純水(UPW)と RCA 標準クリーニング(SC)溶液である SC-1 および SC-2 があります。RCA クリーニング手順によって、チップを傷めずに、ウエハ表面から化学汚染物質や微粒子不純物を除去できます。SC-1(脱イオン水(DIW)に含まれる NH4OH と H2O2)によって、ウエハ表面から有機残留物、膜、粒子が除去されます。次に、SC-2(DIW に含まれる HCl と H2O2)によってイオン汚染物質が除去されます。
フォトレジストポリマーパターンなどの有機材料は、イオン埋め込み後にシリコンウエハの表面から完全に除去する必要があります。このクリーニング手順には、過酸化硫黄混合物(SPM)である「ピラニア」溶液を使用します。これは H2SO4 と H2O2の混合物です。製造プロセスのこの段階でウエハ表面の汚染をなくすには、これらの化学物質の金属不純物を低濃度に抑えることが非常に重要です。
半導体機器の製造では、HNO3も重要な役割を果たします。例えば、単結晶シリコンと多結晶シリコンのエッチングには、HNO3 と HF の混合物が使用されます。アルミニウムのウェットエッチングには、HNO3とリン酸および酢酸の組み合わせが使用されます。
性能証明実験
多くの大手半導体メーカーが、施設やラボで複数の Agilent ICP-MS システムを使用しています。8900 ICP-QQQ は 2016 年の発売以来、SEMI ガイドラインに基づき、前述の多くの化学物質や試薬の分析に広く使用されてきました。以下の例の概要をご覧ください。装置は通常、Microflow ネブライザ(流量:200 uL/min)、石英製サンプル導入システム(オプションでガスポート付き)、白金製インタフェースコーン、s-レンズ、軸方向加速イオンガイド機能付き ORS4で構成されます。
超純水中の ASTM/SEMI 元素のシングルおよびサブ ppt ガイドラインレベルに適合
この研究では、UPW 中の超微量汚染物質の測定に、8900 ICP-QQQ とオプションの m-レンズが適していることを実証しました。m-レンズを用いることにより、イオン化しやすい元素(EIE)である K、Na、Ba、Li のバックグラウンド信号が最小限に抑えられ、ホットプラズマ条件(CeO/Ce 比 < 2 %)を使用して 26 個の SEMIの重要元素すべてを ppt レベルで確実に測定できました。可能性のあるスペクトル干渉はすべて、ノーガスモードと 2 つの反応ガスモードの単一マルチチューンメソッドを使用した MS/MS モードで 8900 を操作することによって除去できました。
図 2 のとおり、すべての元素の BEC と DL は、半導体産業における 0.045 ミクロン未満の線幅での製造に関連する UPW の品質について ASTM と SEMI が設定した推奨値をはるかに下回りました。ボロン以外のすべての値が 0.5 ppt 未満でした。ただし、ICP-MS ジャーナルの前号の記事で報告したとおり、8900 とボロンフィルタ付きのオルガノピューリック ω II システムを組み合わせて使用すると、ボロンでも BEC が 0.63 ppt、DL が 0.12 ppt と改善されました。

SEMI Grade 5 高純度過酸化水素
この研究では、サンプルマトリックスとして、TAMAPURE-AA-10 過酸化水素(35 %)を使用しました。添加元素を安定化させるために、H2O2サンプルに超高純度 HNO3(TAMAPUREAA-10)を加えました。このとき、70 % HNO3 が 1000 倍に希釈され、最終的な硝酸濃度が 0.07 % になるようにしました。混合多元素標準液(SPEX CertiPrep 社、ニュージャージー州、米国)を調製し、H2O2 のブランクマトリックスに 10、20、30、40、および 50 ppt を添加して標準液を調製しました。各溶液の調製は分析の直前に行いました。
H2O2で測定した、硫黄(S)とリン(P)を含む SEMI 規定元素の定量結果と検出下限を表 1 に示します。SEMI 規格で規定されていない元素の結果については、アプリケーションノートをご覧ください。各検出下限は、H2O2のブランクサンプルを 10 回繰り返し測定した結果の 3 シグマとして計算しました。
SEMI C30-1110 Grade 5 に基づく規定元素の最大濃度は 10 ppt です。このため、分析対象元素を 10 ppt(硫黄については 100 ppt)添加しました。添加した各分析対象物について、10 ppt(S については 100 ppt)の濃度で RSD 1.0~8.1 % の再現性が得られました。高純度 35 % H2O2サンプルの一連の分析にかかった時間は、3 時間 40 分でした。

別の研究では 8900 ICP-QQQ を使用して、UPW 中の非金属不純物 P、S、Si、Cl、および H2O2中の P、S、Si に対するスペクトル干渉の問題を克服できました。表 2 の結果から、このような分析困難な元素に対して、8900 ICP-QQQ が優れた性能を発揮することがわかります。特に UPW 中の元素の BEC について、非常に低い値を達成しています。

高純度塩酸に含まれる微量金属元素不純物
(この実験で使用しているような)市販グレードの HCl は 20 % または 36 % であるのに対し、半導体グレードの HCl は 37~38 % です。HCl のすべてのグレードにおいて、塩化マトリックスが非常に高いと複数の多原子イオンが形成され、一部の主要元素への重大なスペクトル干渉の原因となります。例えば H237Cl+ は 39K+、35Cl16O+ は 51V+、35Cl16OH+ は 52Cr+、37Cl16O+ は 53Cr+、35Cl37Cl+ は 72Ge+、37Cl2+ は 74Ge+、40Ar35Cl+ は 75As+に干渉します。この研究では、合計 50 元素(SEMI 規格 C27-0708 Tier-C 仕様の全成分を含む)を、標準添加法(MSA)を用いたマルチチューンモードで動作する 8900 ICP-QQQ で測定しました。20 % HCl に含まれる 50 元素すべてで、1 桁の ppt またはサブ ppt の DL および BEC を達成しました。各チューンモードで取得した定量データは、サンプルごとに自動的に 1 つのレポートにまとめられました。表 3 に、20 % 高純度 HCl で、MSA で測定したすべての SEMI 仕様元素の定量データを示します。酸の濃度の違いを考慮しても、この結果は、SEMI C27-0708 で定められている半導体グレード高純度 HCl の要件より大幅に低い濃度の汚染物質を 8900 ICP-QQQ で測定できることを示しています。

注:ヒ素の DL は高純度グレードの HCl(34 % 高純度グレードを DIW で 20 % まで希釈)で測定しました。これは元のサンプルでこの元素の汚染が疑われたためです。As の汚染は、m/z 91 および 93 で測定したプロダクトイオンスペクトルで確認しました。詳細については、こちらのアジレント技術資料をご覧ください。
半導体グレードの超高純度硫酸中の微量元素の測定
この研究では、42 元素を、MSA を用いたマルチチューンモードで動作する 8900 ICP-QQQ で測定しました。高純度 98 % の H2SO4(多摩化学工業株式会社、日本)を、UPW で 10 倍に希釈しました。10 倍に希釈した硝酸をルーチン分析するには、大きいインサート Pt コーン(18 mm)を取り付けることを推奨します。ドライポンプオプションとボールタイプのインタフェースバルブキットを取り付けることで、ICP-MS 内部コンポーネントの長期的な腐食を最小限に抑えることができます。多元素標準液は、XSTC-331、XSTC-7、XSTC-8(SPEX CertiPrep 社、米国)と Si 単元素標準物質(関東化学株式会社、日本)から調製しました。
Si(44 ppt)、P(3 ppt)、Zn(1.5 ppt)以外すべての元素でサブ ppt の DL を達成しました。DL は、9.8 % H2SO4のブランク溶液を 10 回繰り返し測定した結果をもとに求めました。9.8 % H2SO4 の分析の定量結果(BEC)を表 4a および 4b に示します。回収率と RSD は、9.8 % H2SO4の 20 ng/L 添加溶液を 10 回繰り返し測定して求めました。Ti、V、Zn などのすべての元素で、優れた性能を達成しました。これは、8900 メソッドを使用して、S 起因のマトリックス干渉を効果的に抑制できたことを示しています。


高純度の硝酸に含まれる微量金属元素不純物の直接分析
8900 ICP-QQQ を使用して、希釈していない市販グレード(61~68 %)の HNO3 を直接分析しました。直接分析によってサンプル前処理が簡素化され、希釈中の汚染物質の混入を防ぐことができます。この研究では、8900 ICP-QQQ を使用して合計 49 元素を測定しました。8900 ICP-QQQ はマルチチューンモードで動作し、1 回の分析で各サンプルバイアルに自動的に切り替えられます。すべての SEMI ターゲット元素について、優れた直線性とサブ ppt の DL が得られました。Na、K、Ca、Fe では、典型的な標準添加の検量線を示しました(図 3)。49 元素すべてが、SEMI 規格 C35-0708 Tier-B で 69~70 % HNO3 について規定されている 1 μg/L(ppb)未満という最大限度より大幅に低い濃度で測定されました。
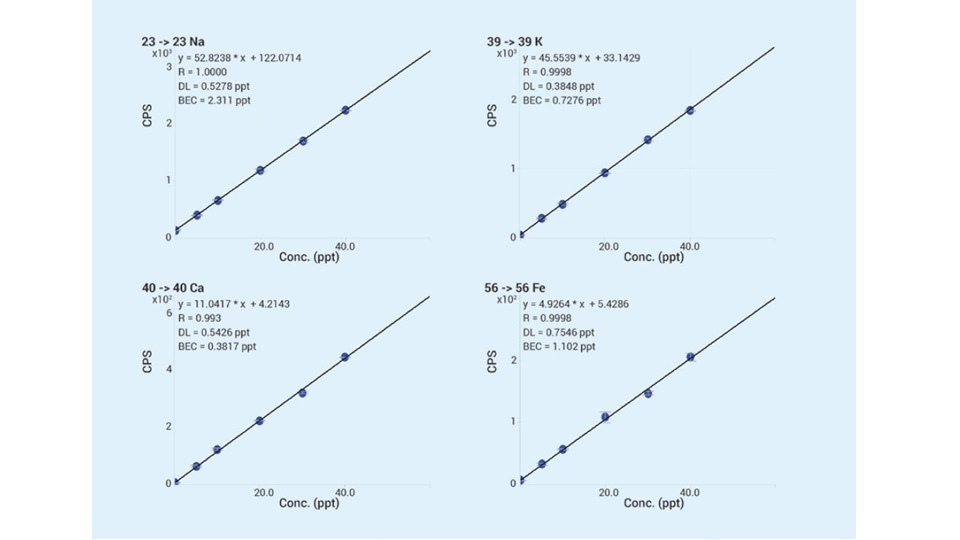
有機系マトリックスの場合
MS/MS モードで動作する Agilent 8900 ICP-QQQ は、水系プロセス化学薬品に含まれる超微量元素の分析に必要な高感度、低バックグラウンド、優れた干渉抑制という特長を備えています。パート 2 では、8900 ICP-QQQ による高純度有機試薬の分析について説明します。
詳細はこちら:
DE-003355





